海外半导体设备巨头巡礼系列:探寻泛林-LAM-成为刻蚀设备龙头的技术&成长逻辑
发布日期:2024-10-04 24:20
来源类型:折纸大百科 | 作者:龙谷修武
| 【494949澳门今晚开什么】 【2024新澳免费资料】 【2024澳门天天开好彩大全】 | 【澳门金牛版正版资料大全免费】 【新澳开奖记录今天结果】 【2024年新澳门王中王资料】 【管家婆最准一肖一码】 【新澳彩开奖结果查询】 【2024澳门六开彩查询记录】 【4949澳门免费资料大全特色】 【2024今晚澳门特马开什么号】 【六开彩澳门网站】 【2O24澳彩管家婆资料传真】
今天分享的是【海外半导体设备巨头巡礼系列:探寻泛林-LAM-成为刻蚀设备龙头的技术&成长逻辑】 报告出品方:东吴证券
泛林半导体(Lam Research)以刻蚀设备起家,通过自主研发和多次并购成长为半导体设备行业巨头。泛林半导体于1980年成立,1984年在美国纳斯达克证券交易所上市。公司早期深耕刻蚀设备,2006年后,公司开始通过并购的方式外扩产品线,自此公司形成以刻蚀、薄膜沉积、清洁为核心的三大主营业务板块。
公司产品围绕刻蚀、薄膜沉积、清洗三大设备领域布局,在刻蚀设备和CVD薄膜沉积设备市场占据领先地位。在刻蚀市场,公司刻蚀工艺包括导体(金属)刻蚀、电介质刻蚀、硅通孔刻蚀,公司2021年全球刻蚀设备市占率约为46%,是全球最大的刻蚀设备供应商。在薄膜沉积市场,公司沉积工艺包括ALD、CVD、ECD,公司2021年CVD设备市占率约为23%,位列第二;ECD设备市占率超90%,垄断市场;ALD设备市占率仅为9%,位列市场前五。在清洗市场,公司主要应用湿法和干法(等离子斜面清洗)两种清洗技术,公司2021年占据全球清洗设备市场份额12%,位列第四。
先进制程+AI发展是行业周期上行的核心驱动力:AI大模型的数据计算量激增,驱动HBM异军突起。TSV(硅通孔技术)是HBM核心工艺,成本占比接近30%。在TSV成本构成中,硅通孔刻蚀成本占比为44%,是TSV工艺的主要成本。先进制程带动刻蚀设备和薄膜沉积设备需求量提升,逻辑器件方面,随着国际上先进芯片线宽向 7m、5m及更先进工艺的方向升级,受光刻机波长限制,芯片制造过程中需要结合刻蚀和薄膜设备采用多重模板工艺。存储器件方面,3D NAND逐渐替代2D NAND,3D NAND 的叠层结构对刻蚀设备功能要求更高,同时沉积设备价量比重上升8pct。


责任编辑:










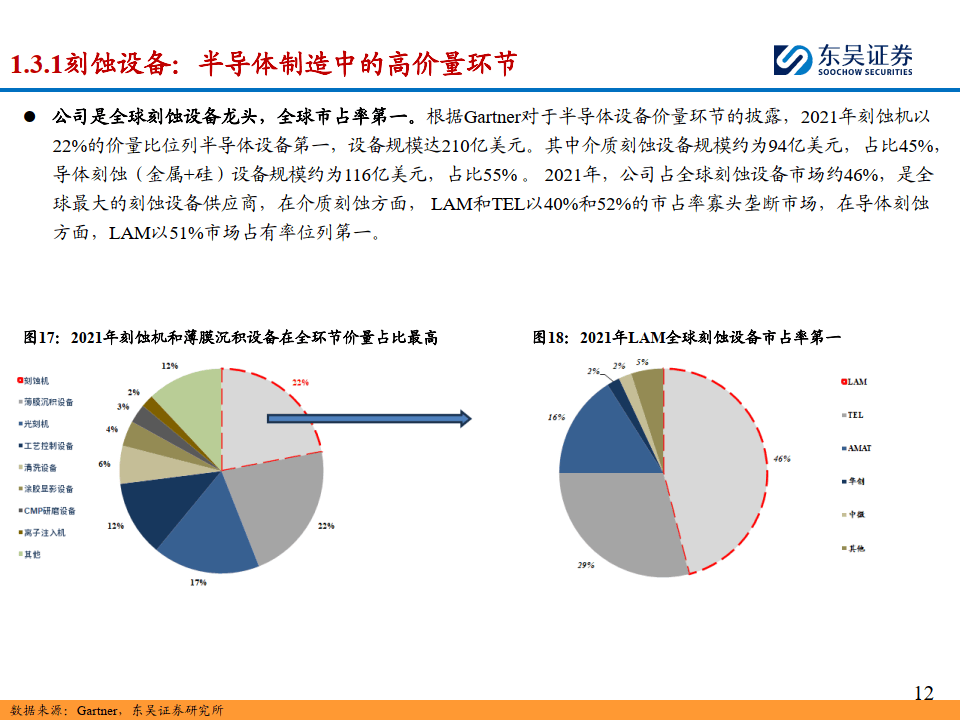

鞠婧祎:
2秒前:今天分享的是【海外半导体设备巨头巡礼系列:探寻泛林-LAM-成为刻蚀设备龙头的技术&成长逻辑】 报告出品方:东吴证券
珍妮·吉格瑞诺:
7秒前:展开全文
馬場良馬:
6秒前:责任编辑:
藤村俊二:
4秒前:先进制程+AI发展是行业周期上行的核心驱动力:AI大模型的数据计算量激增,驱动HBM异军突起。